台积电从原来的晶圆制造代工角色,逐步跨界至封测代工领域(InFO、CoWoS及SoIC等封装技术),试图完整实体半导体的制作流程。
根据不同产品类别,台积电的封测技术发展也将随之进行调整,如同HPC(High Performance Computer)高效能运算电脑将以InFO-oS进行封装,服务器及存储器部分选用InFO-MS为主要封装技术,而5G通讯封装方面即由InFO-AiP技术为主流。
透过上述不同封装能力,台积电除本身高品质的晶圆制造代工能力外,更藉由多元的后段制程技术,满足不同客户的产品应用需求。
台积电积极发展封测技术如InFO-AiP,有效缩减元件体积并强化产品功能
面对AI、5G通讯时代逐步来临,台积电作为晶圆制造的龙头大厂,除了钻研更精密的线宽微缩技术外(由现行7纳米制程,逐步演进至5纳米,甚至3纳米制程条件),封测代工领域也是另一项发展重点指标。透过前述相关封测技术(如InFO-oS、InFO-MS及InFO-AiP等)的开发,台积电试图整合元件制造与封装能力,藉此提供客户较完整的实体半导体之制作流程及服务,以满足各类高端产品轻、薄、短、小的使用目标。
值得一提,台积电在5G通讯领域中主打的InFO-AiP(Integrated Fan-out Antenna in Package)封装技术,于后续即将开展的毫米波(mm-Wave)通讯时程,也将扮演极重要角色。如同前述,结合台积电本身先进半导体制造能力,使线宽精细度得以提高外,再搭配自身研发的独门封装技术InFO-AiP,将驱使整体元件体积有效缩减10%,并且强化天线讯号增益四成成效。
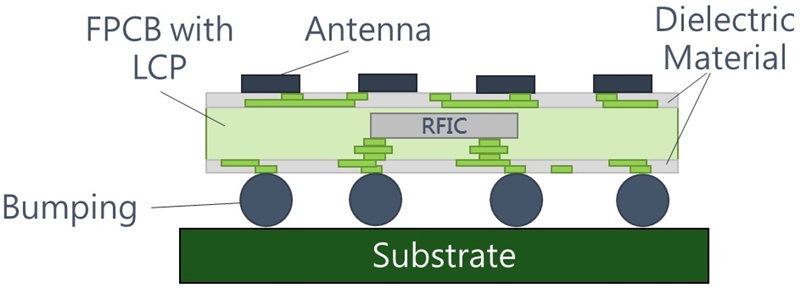
▲台积电之InFO-AiP结构示意图。(Source:拓墣产业研究院整理,2020.2)
不同于封测代工厂商,台积电发展策略仍以晶圆制造为主、封测代工为辅
考量台积电对5G毫米波AiP封装技术之积极抢市态度,对现行封测代工厂(如日月光、Amkor、江苏长电及矽品等)而言,发展策略已产生不小的竞争压力。假若设想于技术研发为企业发展及策略重点时,则台积电于封装策略的开发进程,将有别于其他封测代工厂商的政策目标。
由于台积电的主力强项为高精密晶圆制造代工,将能提供客户复杂且整合度较高的半导体制造服务,藉此因应如AI及通讯元件等高阶产品的市场需求;然而只专精于半导体晶圆制造代工,对龙头厂商的发展性而言似乎略显不足。依现行发展脉络,台积电除了高端晶圆制造外,更进一步搭配自身开发的封装技术,以延续元件制造中线宽微缩的目标趋势,使封装中的重分布层(RDL)金属线路,能透过较精细的制作方式,进行后段的堆叠程序,最终达到有效降低元件体积,并提高产品的功能性。
台积电对半导体的发展策略,仍以晶圆制造为主、封测代工为辅,目前将重心摆在自身高端晶圆制造代工能力,搭配相关先进封测技术开发,期望完整实体半导体的制作流程。
苹果积极投入5G手机开发 AiP模组将成为下一步关键市场上已有消息指出,手机大厂苹果针对5G通讯领域,将于2020年9月推出首款Sub-6GHz手机,并且对毫米波(mm-Wave)使用之频段,可能也将在2020年底或2021年初推出相应的手机产品,以此因应逐渐扩大的5G手机市场需求。
苹果因收购英特尔手机通讯部门,对手机芯片的整合能力又将大幅提升
由于高通长期针对无线通讯芯片进行开发,对于自身产品品质及信赖度皆有严格要求,所以面对如苹果这样的手机大厂来说,直接使用该厂商的相关通讯元件,已是手机出货无虑的品质保证。正当5G时代逐步到来,苹果与高通也结束长达2年的专利诉讼,彼此双方达成和解,并且同意后续iPhone于2022年前搭载高通的Modem(调变解变器)及Baseband(基带芯片)。
虽然如此,苹果也开始思考如何脱离高通无线通讯芯片的束缚,刚好此时遇到英特尔欲出售长期亏损的通讯元件事业部,两者一拍即合,于2019年第四季苹果宣布以10亿美元收购英特尔大部分的智能手机数据机业务。

▲苹果相关购并案及其与高通策略关系图。(Source:拓墣产业研究院整理,2020/02)
对苹果来说,这项收购消息提供其逐步脱离高通牵制的机会,加上先前对Dialog之PMIC(电源管理器)部门的收购,两者消息整合于一起,可确定苹果由于并购案而取得这两大功能,可大幅增进本身手机通讯芯片的整合能力。
另外,现阶段也有消息传出,后续苹果有意开发高度整合化之5G毫米波AiP(Antenna in Package)封装模组,藉此因应5G通讯时代来临。
各家厂商对AiP模组积极参与,苹果因并购案而有机会成为强大竞争者
虽然已有消息指出,苹果将独立开发AiP封装模组,以因应5G毫米波市场需求,但这方面从现有厂商及其供应商公告的资讯,仍无从证实。短期内,iPhone 5G毫米波手机,依旧搭载高通相关AiP产品的可能性较高。
对于现行5G手机之毫米波AiP封装技术,市售产品主要仍以高通推出的QTM052、520等为主,目前还未见到其他类似模组出现(联发科与华为对于AiP封装技术,尚处于相关测试及开发阶段)。然而若以近期并购情形来看,可发现苹果已积极布局于手机芯片整合等领域,对于需高度整合需求的AiP封装模组,应该是苹果下一步发展的重点目标。
面对AiP封装技术的发展趋势,除了现有高通推出的产品外,目前芯片设计商(如联发科与华为等)及封测代工厂商(如日月光、Amkor、江苏长电及矽品等),正尝试积极进入该应用市场中。
假若苹果也有意投入AiP模组应用,或许经过3~5年开发时间,加上本身已有的芯片整合调教能力,应能开发出表现不凡的产品。虽然到时候AiP市场可能已是竞争者众局面,但若以产品与整合芯片能力,苹果将有机会成为能与高通相互较量的强大竞争者。
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。