5G及IoT终端需求发展,SiP系统级封装技术提高了人类生活的便利性
「Semicon Taiwan 2019」展会期间,特别针对半导体的未来发展趋势举行「科技智库领袖高峰会」,封测大厂日月光执行长吴田玉为半导体封测产业的前世今生及未来发展方向提出见解。
由于半导体摩尔定律限制,使得线宽不断微缩、晶体管密度逐步升高,人们从早期的个人计算机发展并搭配QFP(Quad Flat Package)导线架封装方法,演进至现今5G通讯及IoT的SiP(System in Package)系统级先进封装技术。
摩尔定律贡献于终端产品演进,发现它不只带动半导体制程的不断精进,也引领封装技术的逐步提升,遂逐步将终端应用推向智慧化,而5G及IoT应用正开启人类生活的新视野。日月光集团特别在5G通讯应用上,将蓝牙芯片及MCU(微控制器)藉由SiP封装技术整合为一。
在IoT部分,则利用长距离无线通讯(LoRa)芯片搭配MCU进行封装。透过上述异质整合SiP封装技术,使得真无线蓝牙耳机及远距离传输传感器等相关终端产品应用变得更加多元,提高人类生活的便利性。
异质整合能力是决定未来封测技术发展的重要指标
面对现阶段半导体封测技术之发展,异质整合能力将是评估厂商未来发展性的重要指标。针对异质整合的发展特性,将有以下几个评估要点:考量整体的机械性质、元件结构间的热能变化,以及适当材料及程序操作,还有芯片彼此间的互通有无等。
由于必须考量上述因素,在目前摩尔定律限制下,厂商面对整体系统的异质整合程度时,必须衡量自身先进制程及封装技术能力,因此对于现行半导体制造与封测代工厂来说,亟需投入相关封测技术之研发(如2.5D/3D封装、SiP、FOWLP等),以实现终端应用之封装需求。
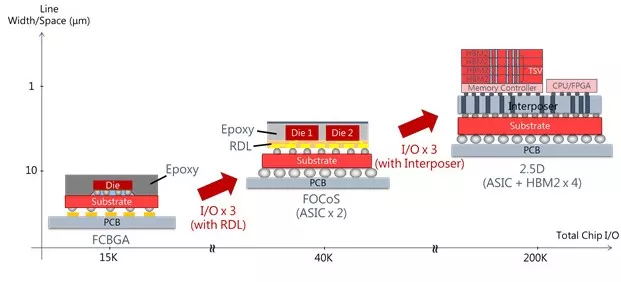
▲2.5D封装技术演进图,source:日月光
值得一提,日月光特别针对AI之FPGA(现场可程序化逻辑闸阵列)芯片,试图从传统FCBGA封装方式,逐步衍生至极低线宽比、极高接脚密度之2.5D封装技术,藉此提升自身异质整合的能力。
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。