IC设计大厂联发科10日公布2020年2月份营收状况,金额来到182.21亿元(新台币,下同),较1月份的198.18亿元减少8.06%,较2019年同期的141.61亿元则是增加28.67%,为近一年来的新低。累计,2020年前两个月营收为380.39亿元,较2019年同期的304.03亿元,成长25.11%。
根据联发科先前公布2020年第1季财测,以美元对台币1比30的汇率计算,第1季营收预估在550亿元到602亿元之间,预计较2019年第4季下滑7%到15%,但是较2020年同期增加4%到14%。而目前以2020年前两个月营收金额380.39亿元计算,3月份营收预期将会落在169.61亿元到221.61亿元之间,应能顺利达成财测目标。
针对2020年第1季营运状况,蔡力行日前在法税会上指出,因为肺炎疫情仍在发展中,以现阶段的资讯来说,尽管短期需求仍有许多有不确定性,联发科仍会透过多元的产品布局,让第1季的营收与毛利率仍皆可较2019年同期成长。此外,在目前状况下,也相信肺炎对全年业务所带来的潜在影响,应该在可以控制范围之内。
而针对2020年号称5G爆发年,对联发科来说不但接力推出天玑(Dimensity)1000及800系列5G SOC抢市,而且在产品性能优异,且时间点领先竞争对手的情况下,使得联发科对此给予相当大的期望值。只是,外资在近期的观察之后,对这样的情况似乎不买单。外资在最新报告中就指出,5G SoC的供需失衡的状况现在已经消失。
因此,预期联发科会出现一些损失,除非联发科降低5G SoC价格以进行竞争。否则,以预计联发科在2020年的本益比20倍来计算,未来目标价将不那么吸引人。
除了5G芯片的持续发展,联发科也持续在主流的4G芯片市场与Wi-Fi无线通讯上着力。因此,日前不仅针对目前4G LTE最高阶处理器Helio P90推出进一步提升版本Helio P95处理器,还携手韩国三星联合推出全球首款搭载联发科客制Wi-Fi 6芯片的8K量子电视。期望藉由三星的产品结合,得以让联发科先进的Wi-Fi 6系列产品推向市场。
各厂商摩拳擦掌研制AiP,台积电、日月光早已跃跃欲试针对5G通讯毫米波(mm-Wave)开发趋势,AiP(Antenna in Package)封装技术将成为实现手机终端装置的发展关键。随着高通(Qualcomm)于2018年7月推出的AiP模组(QTM052及525)陆续问世后,各家厂商对此无不摩拳擦掌,争相投入相关模组的技术研制上;其中半导体制造龙头台积电及封测大厂日月光投控,对此最为积极。
日月光投控对于AiP封装技术之演进,凭借日月光及矽品对于相关封装的长期研发,以及旗下环旭电子增设天线测试实验室的积极投入态度,为此将进一步扩充5G毫米波之发展进程。
高通推出AiP模组后,制造龙头台积电与封测大厂日月光等皆已跃跃欲试
面对5G通讯毫米波逐步发展之际,加上高通已推出的AiP模组产品,各家IDM厂、Fabless厂、制造及封测代工厂商,对此无不跃跃欲试,试图加速开发相关产品,从而应付为数庞大的射频前端市场及5G应用商机。
为了实现AiP封装制造技术,现行除了已开发出InFO-AiP封装技术的半导体制造龙头台积电外,其他封测厂商(如日月光、Amkor、江苏长电及矽品等)也有相应的布局动作,并采取默默耕耘的发展态势,以求提供后续5G通讯毫米波之市场需要。
其中,若以日月光及矽品发展动态为例,现阶段AiP封装技术主要采用RFIC于底层的设计架构,相较于台积电在内层及其他厂商于上层之结构,整体于制作成本上,相较其他产品将更具吸引力。
日月光与台积电于AiP封装技术差异,使产品特性及成本已成为选择难题
针对现行AiP封装技术,进一步比较于台积电内层式之InFO-AiP构造,以及日月光与矽品于底层式的AiP结构差异,可发现RFIC的摆放位置,将是决定模组产品之性能表现(天线讯号损耗、散热机制)及成本高低(制造良率及难易度)的重要指标。
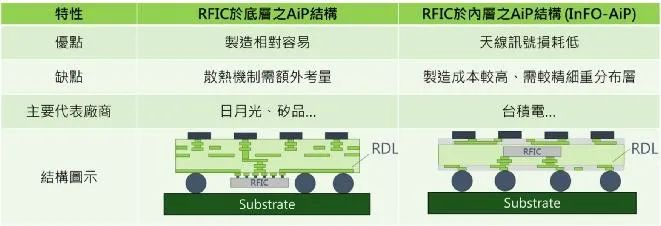
图:RFIC于不同位置之AiP结构比较表(Source:拓墣产业研究院整理)
其中,以日月光与矽品开发之AiP封装架构为探讨主题时,当RFIC放置于底层结构中,此结构确实能有效降低封装成本,并且对于开发流程上也十分有利;由于封测厂商于相关制作流程中,可独立开发重分布层(RDL),并搭配上单独封装好的RFIC,最后再将二者结合于一体,以完成AiP所需的架构。
如此之设计理念,对于管控封装成本而言,已起到节省工序作用;然而却也衍生出另一个难题,“如何将底层的RFIC在运作时产生之热源有效导引出来”,这将是后续亟需克服的关键要务之一。
另一方面,台积电开发的InFO-AiP封装技术,由于运用本身擅长的线宽微缩技术,当RFIC于元件制造完成后,随之进行一系列的后段封装程序;也在此时延伸原有的通讯元件金属线路,将使重分布层得以连结RFIC并导引至天线端,从而达到降低天线端讯号衰弱之效果。
整体而言,虽然日月光及矽品的AiP结构可有效降低成本,但散热机制仍需额外考量,且台积电的InFO-AiP能成功增进产品效能,然而整体封测制造成本却依旧偏高。
由此可见,AiP封装技术于产品特性及成本表现之因素中,已成为一项选择难题,考验未来客户在产品设计及应用需求上应该如何取舍。
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。